Улучшения в технологии MOSFET и IGBT
В настоящее время наиболее важными целями при разработке MOSFET и IGBT кристаллов являются:
- уменьшение падения напряжения в открытом состоянии
- уменьшение потерь на переключение
- способность выдерживать перегрузки (по току, напряжению, условиям коммутации
- высокое напряжение для высоковольтных транзисторов
- соответственно a).c) увеличение плотности тока
- также, чтобы вместе с e) увеличился ток на кристалл и уменьшилась его площадь и стоимость
- оптимизированное низкое насыщение и высокоскоростные IGBT
- внутренний контроль, защита и встроенный драйвер


Рис. 1.13
а) Продолженная характеристика заряда затвора IGBT для управления
затвором между VGG+ и VGG-
б) Малосигнальная емкость IGBT
За последние годы главной целью разработчиков было улучшение конструкции горизонтальной и вертикальной ячеек, усовершенствование структуры ячейки и успешная обработка очень тонкой кремниевой подложкой. Кроме освоения тонкослойной технологии (толщина слоя 100 мкм), например, стало возможно изготовление IGBT с исключительно малыми потерями на 600 В [164].
В настоящее время потенциальные возможности лежат в оптимизации ячейки кристалла. В первую очередь существуют новые высокодисперсные структуры, такие как S-FET от SIEMENS, благодаря последним саморегулирующим процессам, основанным на сопротивлении в открытом состоянии, а также усовершенствование переключение и стабильность [216]. Эта структура, которая применяется для одинаковых форм и для современных IGBT высокой плотности, содержит затворы с двойной имплантацией и распорки в боковой области (рис.1.14).
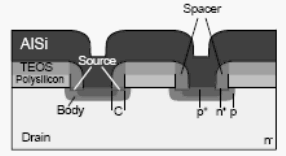
Рис. 1.14. Затвор с двойной имплантированной структурой (Siemens S-FET) [298]
Позже разработанная структура для MOSFET и IGBT, которая вытеснила стандартную структуру затвора, это trench-gate, с вертикальным расположением канала в р-источнике (рис.1.15).
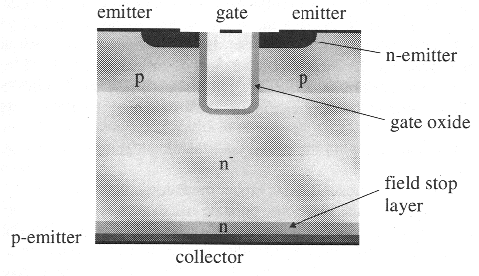
Рис. 1.15. IGBT с trench-gate и слоем field stop
Так как эта структура обеспечивает большую активную поверхность кристалла, управление каналом становиться легче и может быть при меньших сопротивлениях канала. Потери в открытом состоянии уменьшаются примерно на 30 %. Кроме того, поверхность ячейки может быть снова уменьшена, что увеличивает плотность тока, уменьшает потери в открытом состоянии, улучшает стабильность и уменьшает потери при коммутации при большем напряжении пробоя по сравнению с планарными MOSFET и IGBT. К недостаткам можно отнести уменьшение стабильности при коротком замыкании приблизительно в 3 раза выше емкость затвора по сравнению с емкостью планарных элементов.
Также разработан так называемый IEGT (Injection Enhanced Gated Transistor), инжекционный транзистор с обогащенным затвором, для больших напряжений (4.5...6.5 кВ) на технологии trench; благодаря структуре эмиттера затруднен процесс утечки дыр, что привело к концентрации носителей заряда в открытом состоянии подобно тиристорам [194].
Ощутимые улучшения высоковольтных силовых MOSFET возникли при появлении CoolMOS от Siemens в 1998 [216]. Как показано на рис.1.16, структура MOSFET была дополнена р-проводящей областью в дрейфовой зоне, которая подсоединена к р-ячейкам.
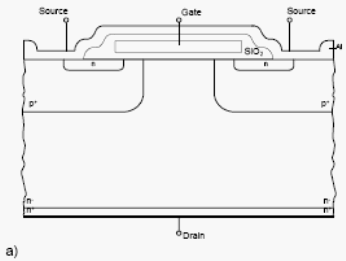 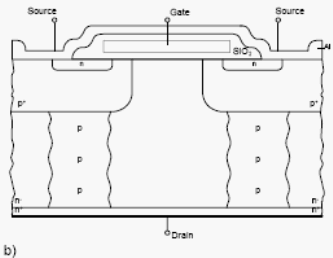
Рис. 1.16. Структура MOS-ячеек
а) традиционная структура
б) структура CoolMOS
При прямом напряжении в выключенном состоянии электрическое поле распределяется не только вертикально но и горизонтально, область n- -дрейфа может быть значительно уменьшена по сравнению с традиционными MOSFET, и в то же время возрастает проводимость. Сопротивление в открытом состоянии RDS(on) уже не возрастет экспоненциально, как это описано в п. 1.2.1 (экспонента 2.4.2.6), а только линейно до напряжения пробоя V(BR)DS. Поэтому, потери в открытом состоянии для 600 В CoolMOS, например, будут уменьшены в пять раз по сравнению с обыкновенными MOSFET при той же площади кристалла. Требуется только 1/3 предыдущей поверхности кристалла для прохождения такого же тока. Потери на переключение будут уменьшены вдвое, потери в открытом состоянии уменьшаться приблизительно на 35 %; благодаря меньшей площади кристалла, снижается емкость и заряд затвора на треть [216]. Однако недостаток - плохой динамический режим обратных диодов в структуре CoolMOS. Это ограничивает их применение при «жесткой» коммутации с индуктивной нагрузкой.
Дальнейшие улучшения будут с использованием других полупроводниковых материалов, таких как карбид кремния (SiC). По сравнению с Si, для пробоя SiC требуется в десять раз большая интенсивность поля. Несмотря на ограниченную подвижность электронов, сопротивление в открытом состоянии уменьшается в соотношении 1/300 к униполярным компонентам, что гарантирует применение при напряжениях выше 1000 В. Как для биполярных SiC . компонентов, меньшая дрейфовая площадь приводит к уменьшению накопленного заряда. С одной стороны энергетический зазор, который в 3 раза больше, чем для Si, допускает рабочие температуры до 500°С; с другой стороны пороговое напряжение биполярных компонентов увеличивается до 2,5 В. Другие нежелательные эффекты состоят в значительно большей емкости перехода по сравнению с Si, и сегодня все еще возникают проблемы в технологии; диффузия примесей практически невозможна, нереализуемы большие поверхности без дефектов, и сегодня основные технологии не применимы для SiC [282], [124], [130].
Интегрированный контроль, защита, функции драйвера или других цепей в кристалл более важна при малых напряжениях (например, автомобильная электроника) или при малых токах (например, товары широкого потребления) в серийных приборах. Например, функции драйвера, защиты, управления и диагностики было встроены в кристалл SMARTPOWER-транзистора, это привело к уменьшению потерь мощности и к улучшению надежности, не говоря уже о миниатюризации [277], [213], [232].
Простейший способ создания, например, элемента защиты и датчика тока, напряжения или температуры возможно путем встраиванием в поверхность кристалла. Можно вспомнить популярные разработки SENSFET и Sence-IGBT, в которых ток истока или эмиттера проходит параллельно через главную и отдельную измерительную цепь. Благодаря обратной связи из измерительной цепи в управляющую цепь, измеряемый ток уменьшается с возрастанием сопротивления датчика [194]. IGBT с датчиками интегрированы во многие IPM. TEMPFET имеет встроенный датчик тока, который также служит как индикатор перегрузок по току и который при перегрузках закорачивает затвор-исток.
PROFET и HITFET, например, содержат полный драйвер с цепями защиты от коротких замыканий и перегрузок по току, напряжению и перегреву, защитой затвора, индикатором нагрузки и т.д. [4], [277]. PROFET выпускается в одиночном и многоканальном исполнении high-side на напряжение 60 В. В отличие от ключей high-side, у low-side нет достаточного напряжения для защиты логики при открытом состоянии MOSFET. Поэтому, встроенный датчик температуры в HITFET будет уменьшать напряжение затвора при высоких температурах кристалла так, что напряжение стока может возрасти до минимального значения напряжения источника (3 В) и цепь защиты сработает.
|