Различие структур и функциональных принципов
В последующем описании мы ограничимся n-канальными обогащенными силовыми IGBT и MOSFET (обогащенные транзисторы), основными транзисторами, используемыми в силовых модулях. При управлении положительным напряжением образуется проводящий канал с электронами в качестве носителей (основных носителей) в существующей p-проводящей пластине кремния. Без управляющего напряжения они запираются (автоблокировка).
Другие разработки, которые не будут описываться в этой части в дальнейшем, это р-канальные усиленные транзисторы (индуцированный положительным зарядом в обедненном канале p-типа с помощью отрицательного/блокировочного напряжения) а также n- и р-канальные обедненного типа (обедненные транзисторы), которые проводят без управляющего напряжения (автопроводимость). В этих транзисторах управляющее напряжение порождает свободную от зарядов зону, которая прерывает основной поток тока. В большинстве случаев применяется вертикальная структура, как показано на рис.1.2 и рис.1.4, где затвор и исток расположены в верхней части кристалла, в то время как низ кристалла работает как сток (MOSFET) или коллектор. Ток нагрузки проходит вертикально через кристалл.
Силовые MOSFET и IGBT, показанные в разрезе, имеют планарную структуру затвора, т.е. в проводящем состоянии образуется «боковой» (горизонтальный) канал. Планарный затвор, который в дальнейшем был усовершенствован в двойной имплантированный затвор, в современный транзисторах высокой плотности является преобладающей структурой затвора для MOSFET и IGBT до сегодняшнего дня.
Однако, недавно разработанные транзисторы имеют «траншейную» структуру затвора, с интегрированным вертикально затвором. При включении вертикальный канал образуется на двух сторонах затвора. Эти и другие разработки будут рассмотрены в разделе 1.2.4.
Боковые MOSFET- и IGBT-структуры взяты из микроэлектроники, также имеют стоковый или коллекторный слой, расположенный на поверхности кристалла - n+- (MOSFET) или р+-. Ток нагрузки проходит вертикально через кристалл. Так как n-зона может быть изолирована от подложки оксидным слоем, то несколько изолированных MOSFET или IGBT можно выполнить на одном кристалле.
Так как боковые транзисторы могут выдерживать только 30 % плотности тока от транзисторов вертикальной структуры, поэтому требуется больше места для сборки. Структурная схема силовых MOSFET (рис.1.2) как и IGBT (рис.1.4) состоит из кремниевой микроячеистой структуры с более чем 820000 ячеек на см2 (последние высокотехнологичные 60 В MOSFET) или около 100000 ячеек на см2 (высоковольтные IGBT) расположены на кристалле площадью 0,3-1,5 см2.
Разрезы ячейки показывают аналоговую структуру зоны контроля MOSFET или IGBT. n--зона должна занимать свободную от заряда зону в выключенном состоянии и обеспечивать р-заряженными ячейками с низкой граничной (р-) и высокой центральной (р+) примесями. Эти ячейки также включают n+ кремниевые слои, которые соединены с металлизированным алюминием электродом истока (MOSFET) или эмиттера Зона управления (затвор), состоящая, например, из n+ поликристаллического кремния встроена в тонкий изолирующий слой SiO2 над n+ областью.
При подаче достаточного положительного напряжения управления между затвором и истоком (MOSFET) или эмиттером (IGBT) возникает инверсионный слой (проводящий канал) в р-области под затвором. Электроны могут проводиться от истока или эмиттера к n- дрейфовой области через этот канал. В противоположность идентичным структурам MOSFET и IGBT, включающих n- зону, различия в третьем электроде, который будет определять все последующие функции.
Рис.1.2 поясняет структуру и функции вертикального n-канально-обогащенного силового MOSFET с планарной структурой затвора.
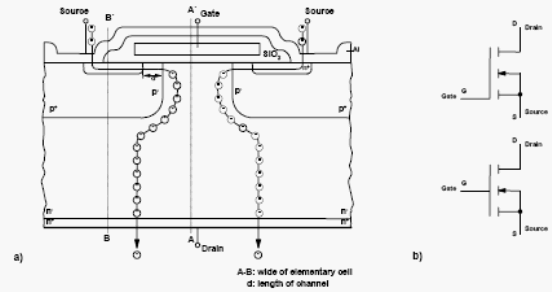
Рис. 1.2. Силовой MOSFET (SIPMOS Siemens)
А-В: ширина элементарной ячейки, d: длина канала
а) MOSFET-ячейка при заряде во включенном состоянии;
б) обозначения ключа
Структура слоев MOSFET, описанная выше, является результатом эпитаксиальных, имплантационных и диффузных процессов на основе n+ -проводящей кремниевой пластине с контактом стока на другой стороне.
Электроны, проходящие под действием электрического поля между стоком и истоком, притягиваются контактом стока, таким образом, поглощая свободную от зарядов зону, следовательно, напряжение сток-исток будет уменьшаться и основной ток, (ток стока) будет в состоянии протекать. Так как электроны проводят ток на 100 % и являются основными носителями заряда в n- -дрейфовой области, то n- -зона с высоким сопротивлением не будет наполняться биполярными носителями заряда; MOSFET является униполярным компонентом.
Тогда как сопротивление сток-исток в открытом состоянии низковольтного MOSFET формируется сопротивлениями единичных ячеек от 5 % до 30-95 % от RDS(on) при высоком обратном напряжении, то оно состоит из n- - эпитаксиального сопротивления области.
Поэтому, падение напряжения в открытом состоянии
| VDS(on) = ID · RDS(on) |
с ID: ток стока и |
| RDS(on) = k · V(BD)DS2.4.2.6 |
с k: постоянная константа, например k= 8.3 ·10-9 А-1 для поверхности кристалла 1 см2; |
V(BD)DS - прямое напряжение пробоя сток-исток как теоретический предел значения для современных доступных MOSFET всегда выше для MOSFET на 200.400 В в закрытом состоянии, чем для биполярных транзисторов, и способность пропускать ток хуже. Недавно разработанные структуры с улучшенными параметрами будут рассмотрены в 1.2.4.
С другой стороны, отсутствует эффект сохранения заряда, так как основные носители заряда способны только к перенесению заряда. Можно получить очень короткое время переключения, однако для этого потребуются большие токи управления для изменения внутренней емкости в случае протяженных компонентов (высокие токи/напряжения) со значением порядка 0,3 mС на см2 поверхности кристалла. Емкости, являющиеся результатом физической структуры MOSFET наиболее важные паразитные элементы на рис.1.3; их влияние на характеристики элементов будут описаны в соответствующих главах.
 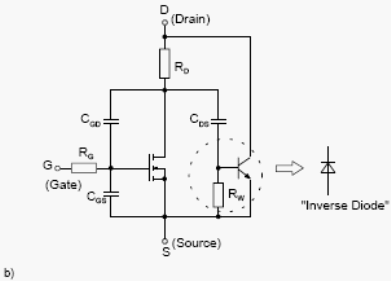
Рис. 1.3. Силовой MOSFET с наиболее важными паразитными элементами
а) паразитные элементы внутри структуры ячейки;
b) эквивалентная схема с паразитными элементами
Следующая таблица 1.3 поясняет названия и возникновение паразитных емкостей и сопротивлений.
| Обознач. |
Описание |
|
| CGS |
Емкость затвор-исток |
Перекрывающая металлизация затвора и истока; зависит от напряжения исток-сток. |
| CDS |
Емкость исток-сток |
Соединенная емкость между n- - дрейфовой зоной и р-ячейкой; зависит от поверхности ячейки,
напряжения пробоя сток-исток и напряжения сток-исток. |
| CGD |
Емкость затвор-сток |
Емкость Миллера; возникает при перекрытии затвором n- - дрейфовой зоной. |
| RG |
Сопротивление затвора (внутренее) |
Сопротивление поликристаллического кремниевого затвора; в модулях с несколькими транзисторами часто требуется дополнительное последовательное сопротивление для минимальной генерации между кристаллами. |
| RD |
Сопротивление стока |
Сопротивление n- - зоны; часто основная составляющая сопротивления открытого MOSFET. |
| RW |
Боковое сопротивление р-ячейки |
Сопротивление база-эмиттер паразитного n-p-n биполярного транзистора. |
Рис.1.4 поясняет структуру и функции вертикального n-канального обогащенного IGBT
с планарной NPT (не смыкаемой) структурой затвора.
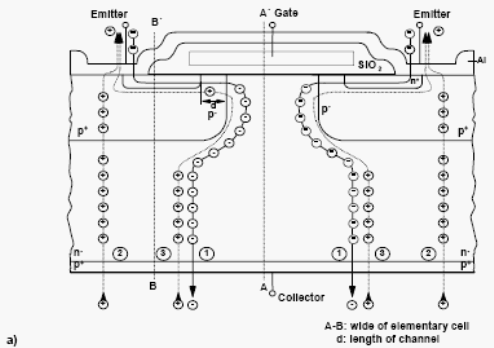 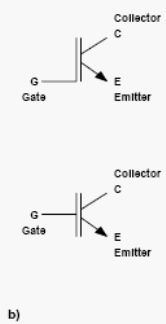
Рис. 1.4. IGBT с NPT-структурой
а) IGBT-ячейка при распределении заряде в открытом состоянии;
б) обозначения ключа
В отличие от MOSFET, IGBT содержит p+-проводящую область с соединением к коллектору ниже n-зоны.
По прохождении n- дрейфовой области, электроны попадают в p+-область, тем самым, располагая положительные носители заряда (дыры) к инжектированию из p+-зоны в n- зону. Инжектированные дырки будут проходить прямо из дрейфовой области к p-контакту эмиттера, чем ближе к краю эмиттера проходит MOS канал и n-ячейка, тем лучше. В этом случае n- -дрейфовая область будет наполнена носителями заряда, которые проводят основной ток (ток коллектора); это обогащение зарядом приведет к снижению пространственного заряда и, следовательно, к снижению напряжения коллектор-эмиттер.
Хотя по сравнению с линейным сопротивлением MOSFET в открытом состоянии, IGBT имеет дополнительное пороговое напряжение на pn-переходе коллектора, но напряжение на открытом высоковольтном IGBT (более 400 В) меньше, чем у MOSFET из-за обогащения основными носителями высокоомной n- зоны. По сравнению с MOSFET, IGBT рассчитан на значительно больший ток и напряжение при одинаковых поверхностях кристалла. С другой стороны, остаточный заряд Qs, который не был экстрагирован за период уменьшения напряжения на коллекторе, должен рекомбинировать в n- зону во время выключения. Qs имеет практически линейную характеристику при малом значении тока и растет пропорционально прямому току в соответствии с радикальным законом:
| Qs ~ I0.8.1 |
при малых значениях прямого тока |
| Qs ~ I0.8.1 |
при номинальном токе и при перегрузках по току |
| Qs ~ V(BR)CE2.2.7 |
|
Обогащение накопленным зарядом и процесс истощения вызывают потери на переключение, задержку (время накопления) и «хвост» коллекторного тока при выключении (см 1.2.3).
За исключением NPT-структуры, показанной на рис.1.3, в настоящее время также применяется PT-структура. Это была основа первых IGBT. Различают две основные структуры PT-IGBT n+ слой с высокими примесями (буферный слой) между n- и р+ зонами в процессе изготовления. Тогда как n- и n+ слои в PT-IGBT обычно образуются на р+ основе с помощью эпитаксиального наращивания, основа NPT-IGBT - это тонкая, жестко-примесная n-подложка, с другой стороны которой образуется p+-зона коллектора путем имплантации. MOS-управляющие зоны в верхней части обоих IGBT идентичны по своей планарной структуре.
На рис.1.5 сравниваются обе структуры IGBT и характеристики их элементов поля в выключенном cостоянии.
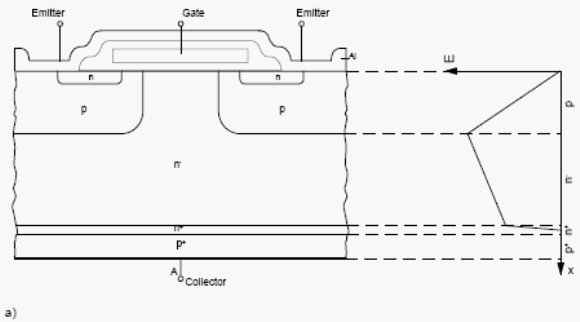
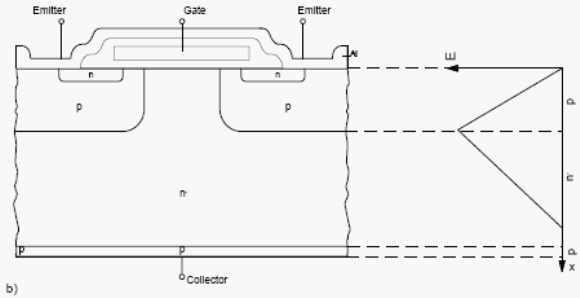
Рис. 1.5. Структуры IGBT с характеристиками электрического поля в выключенном
состоянии
а) PT-IGBT; b) NPT-IGBT
Зона пространственного заряда в PT-IGBT или IGET (Е-эпитаксиальная структура) проходит через всю n- область в выключенном состоянии. Для того, чтобы поддержать эпитаксиальный слой насколько возможно тонким и для высоких напряжений в выключенном состоянии, электрическое поле уменьшается высокопримесным n+ буфером в конце n- дрейфовой области.
В NPT-IGBT или IGHT (Н-однородная структура) n- дрейфовая область создана достаточно большой, так что электрическое поле может полностью разрядиться внутри n- дрейфовой области в выключенном состоянии при максимальном внешнем напряжении. Электрическое поле не может проходить через всю n- зону (структура со смыканием) в допустимой области работы.
Для дальнейшего пояснения функций IGBT и различия характеристик PT и NPT компонентов, сначала необходимо рассмотреть эквивалентную схему IGBT (рис.1.6b).

Рис. 1.6. Ячейка IGBT (NPT-структура) с наиболее важными паразитными элементами
а) паразитные элементы внутри структуры ячейки;
b) эквивалентная схема с паразитными элементами
Обозначения паразитных емкостей и сопротивлений на рис.1.6 аналогичны рис.1.3.
| Обознач. |
Описание |
|
| CGE |
Емкость затвор-эмиттер |
Перекрывающая металлизация затвора и истока; зависит от напряжения исток-сток. |
| CCE |
Емкость коллектор-эмиттер |
Соединенная емкость между n- - дрейфовой зоной и р-ячейкой; зависит от поверхности ячейки, напряжения
пробоя сток-исток и напряжения сток-исток. |
| CGC |
Емкость затвор-коллектор |
Емкость Миллера; возникает при перекрытии затвором n-- дрейфовой зоной. |
| RG |
Сопротивление затвора (внутренее) |
Сопротивление поликристаллического кремниевого затвора; в модулях с несколькими транзисторами часто требуется дополнительное последовательное сопротивление для минимальной генерации между кристаллами. |
| RD |
Дрейфовое сопротивление |
Сопротивление n- - зоны (основное сопротивление p-n-p транзистора). |
| RW |
Боковое сопротивление р-ячейки |
Сопротивление база-эмиттер паразитного n-p-n биполярного транзистора. |
Кроме внутреннего сопротивления и емкости, эквивалентная схема IGBT также представляет свойства идеального MOSFET и паразитного n-p-n транзистора: n+ -эмиттерная зона (эмиттер)/р+-ячейка (база)/n-дрейфовая зона (коллектор) с боковым сопротивлением р+-ячейки под эмиттером, как сопротивление база-эмиттер RW. Кроме того, может
сформироваться p-n-p транзистор последовательностью р+-коллектор (эмиттер)/n--дрейф (база)/ р+-ячейка (коллектор), которые представляют вместе с n-p-n транзистором также и тиристорную цепь.
Запирание этого паразитного тиристора может произойти в основном во время проводящего состояния (когда достигается критическая плотность тока, которая уменьшается с ростом температуры кристалла), а также в выключенном состоянии (динамическое запирание из-за увеличения «дырочного» тока по сравнению с открытым состоянием)
M · (anpn + apnp) = 1, где anpn, apnp = aT · gE
- M: коэффициент умножения;
- anpn, apnp: усиление тока одним транзистором в базовой цепи;
- aT: коэффициент передачи тока базы;
- gE: эффективность эмиттера.
Это приводит к потере возможности контроля IGBT и поэтому к его выходу из строя.
Следующие измерения будут надежно предохранять запирание в современных IGBT во всех возможный статических и динамических условиях работы; плотность тока выключения динамического запирания, например, превышает плотность тока в 15 раз. Во-первых, сопротивление база-эмиттер RW n-p-n транзистора уменьшается посредством:
- - высокого добавления примесей р+ -области прямо под n-эмиттеры, и
- - укорачиванием n-эмиттеров до такой степени, что пороговое напряжение на диоде база-эмиттер n-p-n транзистора не будет достигаться при любых возможных состояниях.
Кроме того, дырочный ток (ток базы n-p-n транзистора) поддерживается на минимальном уровне низким усилением тока в p-n-p транзисторе, однако, режим переключения и надежность должны быть оптимизированы с характеристиками проводящего состояния, которые также значительно зависят от конструкции p-n-p транзистора. Это приводит к тому, что PT- и NPT-IGBT транзисторы производятся различными способами.
Для PT-IGBT эффективность (эмиттерная) дырочной инжекции из р+ зоны в n- дрейфовую область очень высока, так как подложка очень толстая и высокопримесная. Усиление p-n-p тока может быть уменьшено только с помощью коэффициента передачи базы (n- дрейфовая зона, n+ буфер) обеспечивая дополнительные центры рекомбинации (т.е. добавлением примеси золота или облучение электронным пучком), чтобы уменьшить время жизни носителей заряда в n+ зоне. Дырочный ток добавляет 40-41 % к общему току.
В случае NPT-IGBT зона р+ эмиттера создается на коллекторе имплантацией немного тоньше, чем в PT-IGBT, основе. Поэтому концентрация примеси может быть прямо измерена при производстве подложки. Очень тонкий р+ слой гарантирует очень низкую эмиттерную эффективность E = 0,5) p-n-p транзистора, поэтому нет необходимости уменьшать коэффициент передачи тока базы путем уменьшения времени жизни носителей заряда. Дырочный ток составляет 20.25 % общего тока.
По сравнению с PT-IGBT, NPT-IGBT имеют следующие преимущества, являющиеся результатом минимизации эмиттерной эффективности, большим временем жизни носителей заряда и возможностью более точного расчета, который будет рассмотрен в частях 2 и 3:
- положительный температурный коэффициент напряжения в открытом состоянии (автоматическая статическая балансировка при параллельном соединении);
- более низкий, но частично удлиненный хвост тока выключения; меньшие потери выключения при Тj = 125 °С,
- (в случае жесткого переключения) меньшее время переключения и уменьшение потерь;
- значительное уменьшение температурной зависимости времени переключения /потерь переключения (Тj = 125°С) и тока хвоста;
- увеличение стабильности при перегрузках по току, с помощью улучшенного ограничителя тока в случае перегрузок.
По сравнению с эпитаксиальной подложкой PT-IGBT, современное производство однородной n- -основы, как базового материала для NPT-IGBT, более предпочтительное, так как более тонкие кремниевые подложки хорошо обработаны.
|