Конструкция силовых модулей
Силовые модули отдельных силовых полупроводников (MOSFET или IGBT кристаллов и диодов) являются электрически изолированными от монтажного основания (теплоотвода) и встроены в корпус на общей пластине.
Кристаллы припаяны (или приклеены) к металлической поверхности изолирующей подложки, которая электрически изолирует кристаллы от общей пластины модуля, и в то же время хорошо отводит тепло. Верхние части кристаллов подключены к структурным площадкам металлизированных поверхностей с помощью алюминиевых проводов. Дополнительно, пассивные элементы, такие как резисторы, шунты/ датчики тока или температуры (например PTC . резисторы) могут быть встроены в модуль (гибридно) а также
частично в кристаллы транзистора (монолитно).
Кроме того, «интеллектуальные» силовые модули дополнительно содержат драйвер и цепи защиты, см. п. 1.6.
Используемые в настоящее время изолирующие подложки для силовых модулей приведены в таблице ниже:
Изоляционный материал: |
| керамика: |
оксид алюминия Al2O3 |
органические |
эпоксидная смола |
| нитрид алюминия AIN |
полиимид (каптон) |
| (оксид бериллия ВеО) |
|
| (карбид кремния Si3N4) |
|
Подложки |
| Металлические пластины: |
DCB (Direct Copper Bonding) |
|
|
| AMB (Active Metal Brazing) |
| IMS (Insulated Metal Substrate) |
| Многослойная IMS |
| Тонкопленочные слои: |
TFC (Thick Film Cooper) |
DCB (Direct Copper Bonding)
На рис.1.42 показана структура силового модуля с IGBT и обратными диодами, которая используется в большинстве современных технологий с подложкой из DCB-керамики с Al2O3 или AIN изоляцией, с хорошей температурной проводимостью и высоким изоляционным напряжением.
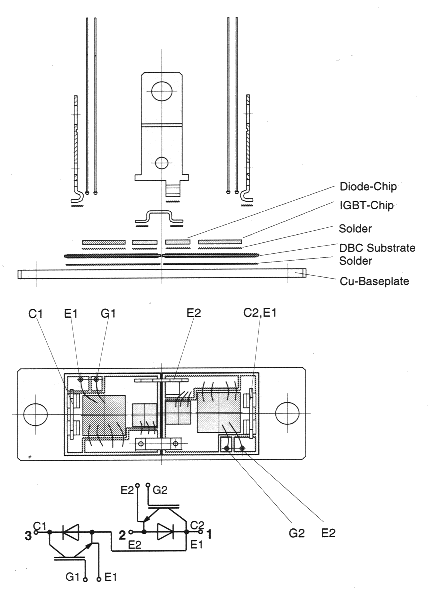
Рис. 1.42. Конструкция IGBT модуля SKM100GB123D в корпусе SEMITRANS 2
Для изготовления подложки DCB, на медную поверхность толщиной около 300 мкм сверху и снизу эвтектически наплавляют при температуре свыше 1000°С изолирующий материал (толщиной 0.38-0.63 мм). После необходимой разводки схема модуля вытравливается на верхней части медной поверхности, кристаллы припаиваются, и контакты кристалла подключаются перемычками. Нижняя часть DCB-керамической подложки припаивается прямо к основной пластине модуля (толщиной около 3 мм), см. рис.1.42.
Другие типы модулей (например SEMITOP, SKiiPPACK, MiniSKiiP) не всегда крепятся на основную пластину и процесса припаивания может не быть. В этих модулях DCB-подложка запрессовуется в теплоотвод благодаря соответствующей конструкции корпуса (см. п. 1.5).
Преимущества DCB-технологии по сравнению с другими конструкциями - это в основном высокая проводимость тока благодаря слою меди, хорошие условия охлаждения благодаря керамическому материалу, высокая адгезионная сила меди к керамике (надежность) и оптимальная теплопроводность керамического материала [52].
AMB (Active Metal Brazing)
Технология АМВ (brazing-«пайка твердым припоем» металлической фольги к подложке) была разработана на основе DCB. Преимущества АМВ-подложки с AIN-керамикой по сравнению с подложками с Al2O3-керамикой в, например, более низком температурном сопротивлении, меньшем коэффициенте расширения и улучшенной способности частичного разряда. Рис.1.43 разъясняет различия между DCB и АМВ.
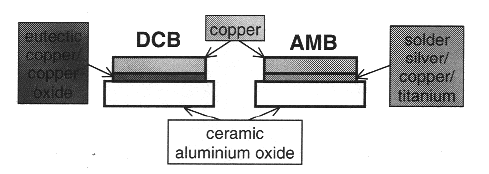
Рис. 1.43
IMS (Insulated Metal Substrate)
IMS сначала использовался в дешевых или маломощных конструкциях, и характеризуется прямым присоединением изоляционного материала к основной пластине модуля. Для изоляции от алюминиевой пластины обычно используются полимеры (такие как эпоксидные смолы, полиамиды). Верхний слой из медной фольги, которая формируется и приклеивается на изоляционную подложку (как в конструкции РСВ), а также разведена травлением (рис.1.44).

Рис. 1.44. Основная конструкция IMS силового модуля [194]
Преимущества IMS в низкой стоимости, филигранной конструкции дорожек (возможность интеграции драйвера и цепей защиты), высокой механической прочности подложки и относительно широкой ее площади, по сравнению с DCB.
Очень тонкий изоляционный слой, однако, приводит к сравнительно высоким общим емкостям поверхности монтажа (см. п. 1.4.2.6). Кроме того, тонкий верхний слой меди только обеспечивает сравнительно низкое распределение тепла, которое улучшается дополнительными металлизированными слоями распределения тепла под кристаллами или добавлением алюминиевых частиц в изоляционный слой.
TFC (Thick Film Cooper)
Как и в DCB, основным материалом для тонкой пленочной подложки является изоляционная керамика, которая прямо приклеена на основную пластину или теплоотвод при помощи силикона или пайкой (рис.1.45).
Дорожки в верхней части керамической подложки выполнены из меди трафаретной печатью. Кристаллы силового модуля или другие компоненты припаяны или приклеены на дорожки.
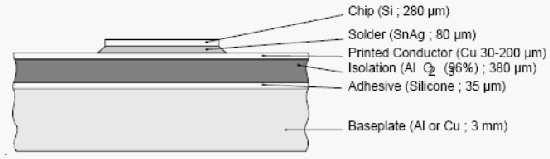
Рис. 1.45. Основная конструкция TFC-силового модуля [194]
TFC-технология также может комбинироваться со стандартной тонкопленочной технологией.
Так как очень низкие сопротивления можно получить при помощи клейких материалов, которые обычно используются в тонкопленочной технологии, и так как изолированные дорожки можно расположить одну над другой и подключить, довольно большое количество компонентов можно интегрировать очень компактно. Однако, очень филигранные дорожки (толщиной примерно 15 мкм) ограничат способность пропускания тока в такой структуре до величины около 10 А.
|