Концепция управляемого аксиального времени жизни (CAL)
Профили рекомбинационных центров, подобные показанным на рис.1.34а и рис.1.34b, можно создать введением протонов или Не++ - ионов в кремний. Некоторое время назад эта технология, требующая ускорений до 10 МэВ, была получена для исследовательских целей, но ситуация изменилась. Основной интерес все больше вызван диапазоном ГэВ, и ускорения при средней энергии доступны для других исследований.
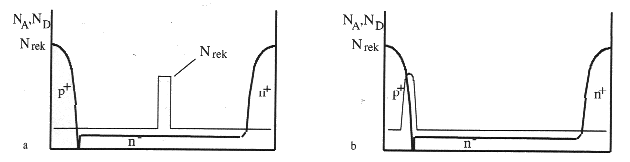
Рис. 1.34. Аксиальная структура рекомбинационных центров, полученная при световой ионизации:
а) узкая зона с более высокой концентрацией рекомбинационных центров в центре n- зоны
b) узкая зона с более высокой концентрацией на pn - переходе
Первое предположение о том, что можно достичь лучших результатов имплантацией зоны высококонцентрированных центров рекомбинации посередине n- - зоны, как это показано на рис.1.34а, было неверным. Расположение такой зоны на pn переходе, как на рис.1.34b, более предпочтительно [292] [293].
В ссылке [147] показано, что соотношение между импульсным обратным током и прямым напряжением улучшается при приближении пика рекомбинации к pn - переходу. Если он расположен прямо на pn - переходе, распределение носителей заряда в открытом состоянии будет обратным. Распределение носителей заряда на рис.1.31 получено при расчете профиля рекомбинационных центров согласно рис.1.35.
Для CAL - диодов пик центра рекомбинации (при Не++ имплантации) расположен в р - зоне, рядом с pn - переходом как на рис.1.35, следовательно, это приведет к уменьшению тока утечки. Не++ имплантация совмещена с откорректированным временем жизни основных носителей, полученного при облучении электронным лучом.
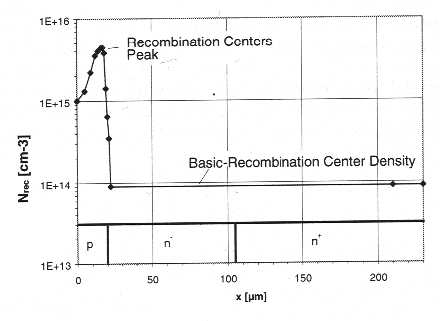
Рис. 1.35. Профиль рекомбинационного центра в CAL-диоде (схема)
На характеристики CAL - диода вместе с IGBT уже была ссылка на рис.1.24. Импульс обратного тока можно уменьшить при помощи уровня пика рекомбинационного центра, который регулируется количеством имплантированного Не++. Больше всего сохраненного заряда в CAL- диоде приходиться на хвостовой ток, которым, с другой стороны, можно управлять при помощи плотности рекомбинационного центра. Уменьшение временем жизни основных носителей приведет к укорачиванию хвостового тока, однако возрастет падение напряжения на диоде. Условиями восстановления можно хорошо управлять при помощи двух параметров: времени жизни основных носителей и количества имплантированного Не++. Таким образом диод будет работать с мягким восстановлением в любых условиях, особенно при малых токах.
CAL-диоды, изготовленные таким способом, обеспечивают высокую динамическую устойчивость. CAL-диоды для 1200 В и 1700 В проверены в лабораторных условиях при соотношениях dI/dt до 15 кА/см2мкс и работали без отказов.
CAL-диоды работают и в условиях рис.1.33. Тест на устойчивость 3.3 кВ CAL-диода показан на рис.1.36. При измерениях на рис.1.35, перегрузка диода усугубляется дополнительной паразитной индуктивностью 0.5 мкГн, из-за которой возникает импульс напряжения 1500 В сразу после коммутации.
По сравнению с другими, CAL-диоды также могут работать в этом диапазоне напряжений при высоких dI/dt (около 2000 А/см2мкс).
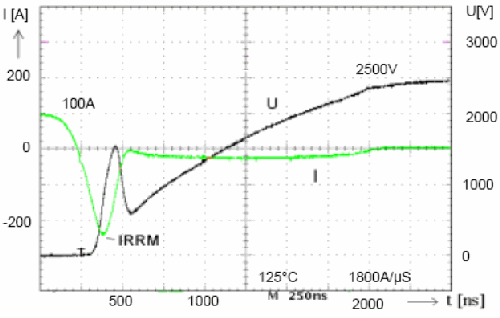
Рис. 1.36. Тест на устойчивость 3300 В CAL-диода
Ширину основы wB можно масштабировать сравнительно точно для CAL-диодов,
подобно определению размеров PT, как это показано в уравнениях 1.10 и 1.11. Это обеспечит
лучший компромисс для сравнительно низкого падения напряжения между параметрами
коммутации и напряжением. Ширина основы также важна для параметров открывания
диода. Напряжение прямого восстановления VFR растет пропорционально wB; обратные
диоды на напряжение 1700 В и более могут вызвать 100 В VFR из-за большого dI/dt при
выключении IGBT. В отличие от обычных диодов, VFR можно уменьшить более чем на 50 %
в 1700 В CAL-диодах [106].
Недавно разработанные обратные диоды для IGBT так же как и снабберные диоды [294] изготавливают по CAL-концепции, потому что:
- динамическая устойчивость является одним из наиболее важных требований,
- масштабирование подобно определению размеров PT улучшает устойчивость к космическим лучам,
- компромисс между падением напряжения и параметрами переключения диода можно установить с помощью вышеупомянутого способа,
- минимальное VFR можно получить для снабберных диодов
- можно добиться меньшего тока утечки по сравнению с обычным процессом диффузии золотом.
|