IGBT
Выходные характеристики IGBT показаны на рис 1.10.
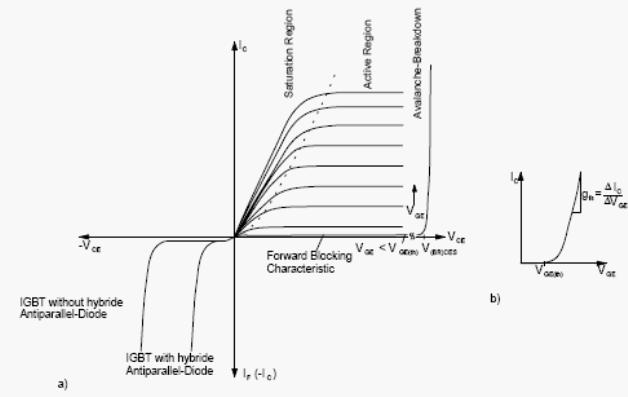
Рис. 1.10
а) выходная характеристика IGBT (n-канальных обогащенных)
b) переходная характеристика IС = f (VGE)
Закрытое состояние при прямом напряжении
По аналогии с MOSFET, ток отсечки коллектор-эмиттер ICES между коллектором и эмиттером очень мал, если напряжение коллектор-эмиттер VCE положительное и напряжение затвор-эмиттер VGE ниже порогового напряжения VGE(th). С ростом VCE п значение ICES медленно увеличивается. При превышении определенного максимального напряжения коллектор-эмиттер VCES, происходит лавинный пробой перехода р+ область/ n- дрейфовая зона/ n+ эпитаксиальный слой (напряжение пробоя V(BR)CES). Физически, V(BR)CES приблизительно соответствует обратному напряжению коллектор-эмиттер VCER биполярного p-n-p транзистора в структуре IGBT (см. рис.1.6). усиленный ток, вызванный лавинным пробоем, может привести к выходу из строя IGBT, со скоростью включения биполярного транзистора. Однако, база и эмиттер практически закорочены металлизацией эмиттера и разделены только боковым сопротивлением р+ области. При некоторых улучшениях IGBT, подобно MOSFET как описано в 1.2.2.1, ток лавинного пробоя в ячейке удерживается на минимальном уровне, что приводит к высокой стабильности при прямом напряжении в выключенном состоянии.
Включенное состояние
Для IGBT прямое открытое состояние при положительном напряжении коллектор-эмиттер VCE и прямом токе коллектора IC также можно разделить на две характерных области (рис.1.10, первый квадрант).
Активный участок
При незначительном превышении напряжением затвор-эмиттер VGE порогового VGE(th), токовое насыщение станет причиной значительного падения напряжения на канале (горизонтальная область на выходной характеристике). Ток коллектора IС контролируется при помощи VGE. Переходной режим, приведенный на рис.1.10, называется, по аналогии с MOSFET, крутизна характеристики прямой передачи gfs:
gfs = dIC/dVGE = IC/(VGE - VGE(th)).
Крутизна характеристики прямой передачи в области среза растет пропорционально току коллектора IC и напряжению коллектор-эмиттер VCE, и падает с увеличением температуры кристалла. При допустимых условиях работы для силовых модулей с несколькими кристаллами, область среза пересекается только во время включения или выключения. Как и для MOSFET, постоянная работа в области среза чаще всего запрещается, так как VGE(th) будет падать при росте температуры и, следовательно, температурная нестабильность между одиночными кристаллами может возникнуть в результате минимальных отклонений при производстве.
Область насыщения
Область насыщения (крутой подъем кривой выходной характеристики), также называемая открытым состоянием при переключении, можно получить так же, как и ID, с помощью внешней цепи. Характер изменения кривой во включенном состоянии можно характеризовать напряжением IGBT VCE(sat) (напряжение насыщения коллектор-эмиттер). По крайней мере, для хорошо запираемых IGBT напряжение насыщения намного меньше, чем напряжение, требуемое для включения такого же MOSFET, благодаря тому, что n- -дрейфовая зона заполняется неосновными носителями. Как уже упоминалось, VCE(sat) для PTIGBT будет падать с повышением температуры и номинальным током, тогда как для NPT IGBT - пропорционально растет.
Работа при обратном напряжении
При обратном напряжении (рис.1.10, третий квадрант), коллекторный pn-переход IGBT смещен в обратном направлении и закрыт, в противоположность MOSFET. Также, благодаря большой n- дрейфовой зоне, по крайней мере, для NPT-IGBT, обратное напряжение для современных IGBT всего около 10 В. За исключением границы кристалла, это происходит благодаря тому, что кристаллы разрабатывались в основном для работы с высоким обратным напряжением и для оптимального рассеяния тепла коллектора.
Ключи IGBT, разработанные для работы с обратным напряжением, должны снабжаться быстрыми параллельными обратными диодами.
Характеристики внешних или гибридных диодов (см. раздел 1.3) отвечают исключительно за открытый режим IGBT при обратном напряжении.
|